版权所有 © 2023 范德耗材 版权所有 津ICP备2023001149号-1
本文中我们通过双乳液和捕获芯片的例子详细介绍了微流体设备制造中涉及的所有步骤。该方案的灵感来源于Ho、Lee和Liu于2016年发表在《科学报告》上的文章,以及Kole等人于2015年发表在J.Res.Natl上的文章。
1. 微流控芯片设计:
下面介绍的设计旨在产生双乳液液滴。
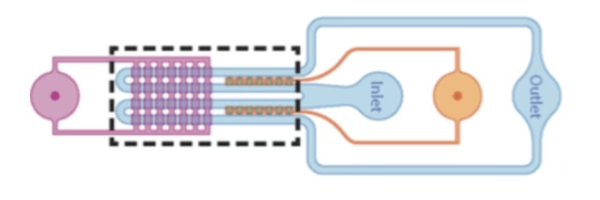
该芯片装置有两个PDMS层,由一个可变形的微流体通道和两个独立的控制阀组组成。控制阀组1(紫色)有助于将液滴捕获在捕获室内,而控制阀组2(橙色)提供捕获液滴的平面内压缩。微流体通道位于控制层下方,并由薄的、可变形的PDMS膜分隔。摘自Ho,Lee和Liu 2016年科学报告。
您可以在下面找到一个详细的方案(摘自Kole等人2015年发表在J.Res.Natl.Inst上),该方案将允许您设计微流体设备
1.首先,有必要使用计算机辅助设计(CAD)软件来设计微流体装置。
2.接下来,我们建议您使用直径为100毫米的晶片的轮廓(这显然取决于您的设备的尺寸)和标准平面作为阵列设备的外部范围,并在晶片的中心约90毫米内对设备特征进行构图,以避免可能的边缘缺陷。
3.要制造具有多个光刻级别的器件,需要将光刻胶应用于图案化元件并在后续光刻级别之间进行对准,我们建议采用以下指示:
3.1.您可以将器件特征(如衬底的下对准标记)放置在第一设计级别上。这种顺序对于在平坦的光致抗蚀剂膜中构造具有垂直纳米尺寸的元件是最优的,该光致抗阻膜保形地施加到非结构化衬底上。
如果在随后的光刻级别中结构化元件的垂直尺寸是关键的,并且如果器件和阵列设计允许,则将元件放置在朝向阵列外围的较低级别上。然后,这种放置将减少这些较低级别元件上离心涂覆的光致抗蚀剂膜在更靠近晶片中心的位置上的厚度变化,然后将在晶片中心放置较高级别的元件。
3.2接下来,下对准标记应朝向晶片的外围放置,以改善角度对准并减少由此产生的膜厚度的径向变化,并且放置在不干扰器件特性的位置。下对准标记的理想放置允许在不覆盖器件特征的情况下在光致抗蚀剂的离心涂覆期间使用单条线性带来掩模多个下对准标记。这保持了较低对准标记的可见性,同时实现了较高水平的光刻。对于每个较高的光刻级别,建议至少包括一对较低的对准标记。
3.3.在第三步中,您可以将微流体通道、入口和出口储存器以及上部光掩模对准标记等器件特征放置在上部设计水平上。如果这些元件的垂直尺寸至关重要,并且器件和芯片设计允许,那么您可以将这些顶级元件放置在更靠近晶片中心的位置。这种布置将受益于膜厚度的减小的变化,这是由于将离心光致抗蚀剂应用于最佳地朝向管芯的外围布置的较低级别元件。因此,衬底上的下对准标记应该通过光掩模上的上对准标记可见,这对于在负色调光致抗蚀剂中建模模具结构来说将主要是不透明的。
3.4.最后,在光刻过程中,可以通过光掩膜将互补对准标记对准基板。